技术动态
晶格失配对InAs基室温中波红外探测器性能的影响
与HgCdTe器件相比,InAs基材料在室温下其载流子迁移率和俄歇复合系数均有明显优势,并且InAs基器件在势垒层材料上有更多的选择,如AlGaSb、AlAsSb、InAsP、InAlAsSb、InAsSbP等,2014年红外领域著名专家波兰院士安东尼教授对中波红外不同探测材料体系做了对比,InAs基探测器在3~5 μm中波室温探测中具有明显优势。
近期,上海理工大学和中国科学院上海技术物理研究所的科研团队在《激光与红外》期刊上发表了以“晶格失配对InAs基室温中波红外探测器性能的影响”为主题的文章。该文章第一作者为段永飞,主要从事新型红外探测材料与器件方面的研究工作;通讯作者为上海理工大学陈泽中副教授,主要从事金属塑性成形CAE与模具CAD/CAM研究等方面的研究工作。
本文研究采用液相外延技术(LPE)生长了InAs基室温红外探测器件材料,通过光学显微镜、扫描电子显微镜、X射线衍射仪分析了外延材料表面形貌、截面形貌与晶格失配的关系。
实验过程
InAs基红外探测器制备
InAs基器件材料的制备采用液相外延法,使用常规水平滑动石墨舟技术进行生长(图1为生长工艺曲线)。外延生长工艺模式采用步冷法,当温度降到生长温度550 ℃时,抽动放置衬底的石墨滑板使InAs衬底依次与熔源材料接触,进行外延层的生长,最终得到InAs基多层薄膜结构器件材料。
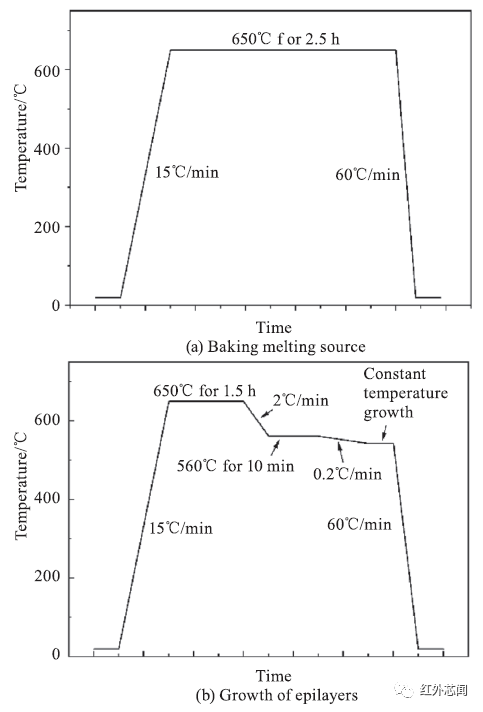
图1 InAs基器件液相外延生长工艺曲线
采用常规光刻和湿法刻蚀工艺)制作直径200 μm台面器件(如图2所示)。在刻蚀出台面结构前,通过匀胶、光刻、显影工艺使用AZ5214光刻胶作为掩膜层将器件台面保护住。采用湿法刻蚀工艺将台面结构以外的外延材料刻蚀掉,刻蚀停止在p型InAsSbP阻挡层。最后,在p型掺杂的InAsSbP阻挡层上和n型掺杂InAsSbP窗口层上利用电子束蒸发做出欧姆接触Ti/Au电极。
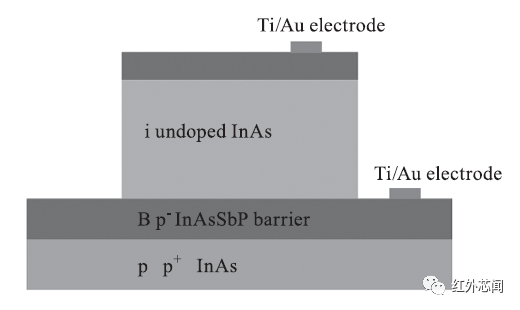
图2 pBin型InAs器件结构示意图
器件性能表征
采用X射线衍射仪(XRD)对样品的结构特性和晶体质量进行表征和分析,测试电压为40 kV,电流为40 mA。采用扫描电子显微镜(SEM)对样品的截面进行观察,测试电压为10 kV。采用I-V测试探针台测试样品的I-V曲线获得器件动态电阻。器件的室温探测率由归一化光电流能谱与黑体响应下探测器光电流相结合得到。采用傅里叶红外光谱仪-获得器件光电流能谱。采用黑体响应测试获得探测器光电流,黑体温度为900 K,调制频率1000 Hz,黑体出光孔径0.8 cm,黑体与探测器的距离为30 cm,探测器输出的光电流信号经前置放大器放大并转化为电压信号后,输入锁相放大器解调后得到。在光电流能谱及黑体响应测试中,探测器均为零偏压状态。
结果与讨论
InAsSbP外延薄膜
通过调整液相外延生长参数如液相组分、生长温度,获得了一系列晶格失配不同的InAsSbP外延薄膜。图3所示为200×放大倍率下的光学显微镜观察的InAsSbP外延薄膜S1~S6样品表面形貌图。采用XRD对InAsSbP外延薄膜的晶格常数和晶体质量进行表征。摇摆曲线的半高宽(FWHM)越窄,单晶的晶格质量越好。图4为S1~S6样品的XRD(400)衍射峰和S1~S6样品InAsSbP外延薄膜的(400)摇摆曲线,外延薄膜与衬底之间的晶格失配通过XRD测得的衍射峰角度代入布拉格方程进行计算。

图3 S1~S6样品光学显微镜表面形貌图
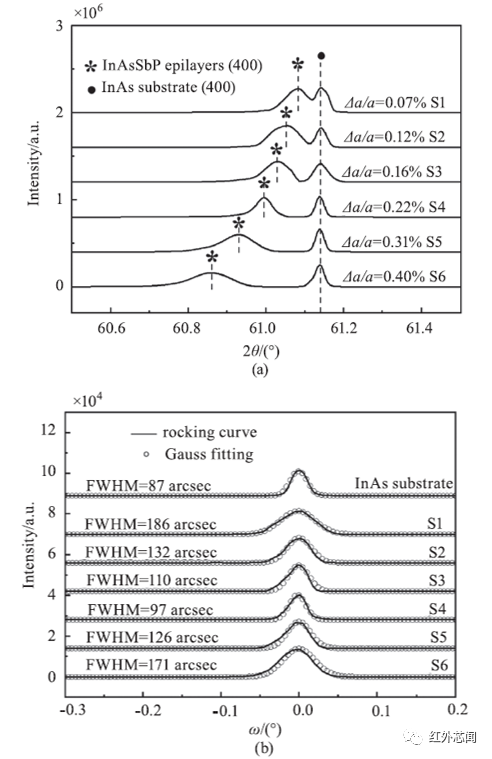
图4 S1~S6样品XRD图及InAsSbP外延膜(400)摇摆曲线图
图3和图4表明,InAsSbP外延层的表面形貌和外延层与衬底之间的晶格失配存在联系。S4样品在室温下与InAs衬底的晶格失配为0.22%,外延层表面光亮均匀,摇摆曲线显示其半高宽最窄,与InAs衬底的摇摆曲线半高宽相当,结晶质量较高。S1和S2样品显示,样品晶格失配在0.1%左右及以下的微正失配时,外延层表面密布点状缺陷。当晶格失配由0.1%左右继续减小至0.1%以下的微小正失配时,点状缺陷密度迅速增加,表面形貌变差,InAsSbP外延层的摇摆曲线半高宽也明显宽化。张永刚等人早期在InAs衬底上使用液相外延技术生长InAsSbP外延层中也有类似情况出现,这可能是因为InAs、InSb和InP的热膨胀系数不同。当晶格失配在0.3%左右继续往正失配方向增加时,“cross-hatch”形貌开始显现,这是液相外延生长过程中一种典型形貌,与位错辅助的应变弛豫和表面台阶流动导致的外延薄膜表面的高低起伏有关。晶格失配增加,“cross-hatch”形貌明显加重,沟壑状纹路出现,说明材料失配位错非常严重,S5和S6样品摇摆曲线的半高宽相比S4样品也有明显宽化,晶格质量变差。
InAs红外探测器件
选取InAsSbP外延层的三种典型表面形貌,生长对应晶格失配0.09%、0.21%、0.40%的InAsSbP外延层组分pBin结构器件,得到样品D1、D2、D3。
采用扫描电子显微镜对各样品的截面进行观察。观察前,将样品沿(100)晶向解理,在A-B腐蚀液中腐蚀3 s。由于样品各层界面处缺陷相比各层材料内部更多,腐蚀速度更快,更容易被刻蚀,因此腐蚀后界面处缺陷更加明显,便于观察到更清晰的界面。各样品的SEM截面形貌如图5所示。样品D1和D3在相同的腐蚀时间下界面处腐蚀很严重,且器件样品的耗尽区即p型InAsSbP阻挡层与本征吸收层之间界面处在腐蚀后相较其他区域发亮并且宽化,缺陷尤为严重。样品D2的SEM截面形貌各外延层间界面平整且清晰,由此可以看出,样品D2各层间缺陷较少,材料质量较高。由此可以判断,晶格失配过大和过小都会导致材料内部缺陷增多,尤其是不同外延层间界面处缺陷密度增加明显。晶格失配在0.21%左右的InAsSbP/InAs系统材料内部缺陷较少,晶体质量较好,这与高分辨X射线衍射谱得到的结果一致。
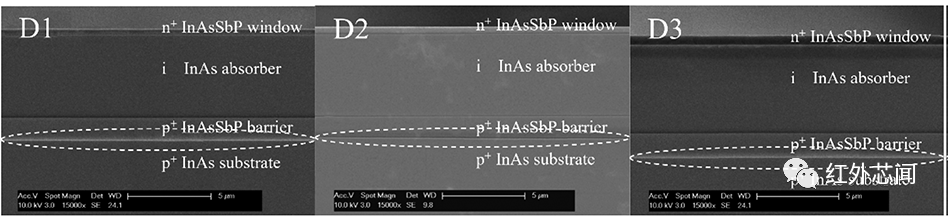
图5 D1、D2、D3器件SEM截面图
将样品D1、D2、D3制备成直径为200 μm的台面型红外探测器器件。图6所示为样品D1、D2、D3制备出的台面型红外探测器的侧壁SEM图。同通过观察SEM截面分析外延层晶体质量原理类似,器件制备过程中的湿法刻蚀工艺也会使材料内部的缺陷扩大。D1和D3样品出现明显侧蚀情况,且D1样品更为严重。对比之下,D2样品表面平整干净,台面形状规则。D2样品材料内部缺陷较少,晶体质量较好,和高分辨X射线衍射谱得到的结果一致。
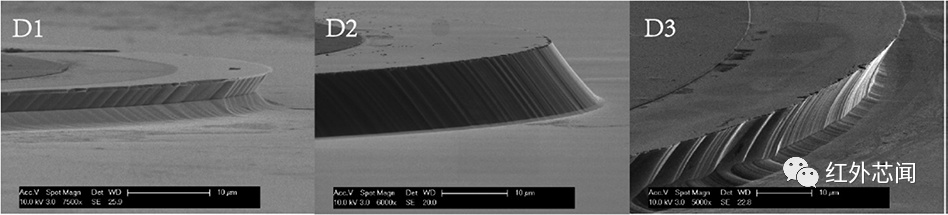
图6 D1、D2、D3器件侧壁SEM图
图7为D1、D2、D3样品制备出的台面型红外探测器的I-V特性曲线。D2样品p-n结特性明显,反向偏压100 mV时漏电流在三个样品中最低,在反向偏压700 mV时仍未出现明显漏电。D1样品在反向偏压100 mV左右时,p-n结开始出现明显漏电,继续增大反向偏压,漏电流急剧增大。D3样品在处于与D1样品相同反向偏压时漏电流比D1样品稍小些,但也在反向偏压200 mV时出现明显漏电。对于pBin结型探测器,其耗尽区位于势垒阻挡层与本征吸收层界面处,零偏电压下,p-n结处于热平衡状态,耗尽区中非平衡载流子的产生速率等同于复合速率,附加偏压后,耗尽区内部缺陷密度如果较大,杂质和缺陷将形成大量的载流子产生复合中心,导致器件的产生复合电流大幅增加。对比三个晶格失配不同的样品,晶格失配在0.21%的器件样品D2暗电流水平最低。
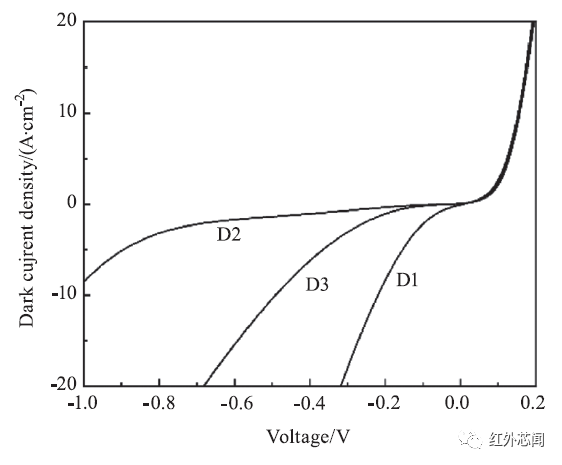
图7 D1、D2、D3器件I-V曲线
对D2样品台面型红外探测器室温探测性能进行了测试。D2样品台面型红外探测器的室温光学响应率和探测率如图8所示。900 K黑体辐照下,器件室温下截止波长为3.5 μm,探测率D*为6.8×10⁹ cm·Hz1/2·W⁻¹,这一性能和国际上红外探测器领军企业美国Teleyne Judson Techologies(截止波长3.60 μm,室温探测率2.5~3.7×10⁹ cm·Hz1/2·W⁻¹)和日本滨松株式会社(截止波长3.65 μm,室温探测率4.5×10⁹ cm·Hz1/2·W⁻¹)在售的商用InAs基红外探测器处于同一水平。


图8 D2器件室温光学响应率图及探测率图
结论
本文采用液相外延技术制备了以InAsSbP材料为器件阻挡层和窗口层材料的InAs基红外探测器,研究了InAsSbP/InAs系统的晶格失配对InAs基红外探测器性能的影响。通过对一系列晶格失配不同的InAsSbP外延薄膜分析发现,不恰当的晶格失配会造成InAsSbP外延层缺陷增多,结晶质量下降。确定出了晶格失配在0.22%左右的InAsSbP外延层晶体质量较好,采用0.22%左右晶格失配的方案制备出的器件暗电流水平较低。通过对InAsSbP/InAs系统晶格失配的研究,制备出了InAs基红外探测器件,并测试得出室温下截止波长为3.5 μm,探测率D*为6.8×10⁹ cm·Hz1/2·W⁻¹,室温探测率已达到较高水平。
上一条:烽火通信400G光传输再创记录 下一条:新型压电传感器能在900℃高温下工作
相关文章
与HgCdTe器件相比,InAs基材料在室温下其载流子迁移率和俄歇复合系数均有明显优势,并且InAs基器件在势垒层材料上有更多的选择,如AlGaSb、AlAsSb、InAsP、InAlAsSb、InAsSbP等,2014年红外领域著名专家波兰院士安东尼教授对中波红外不同探测材料体系做了对比,InAs基探测器在3~5 μm中波室温探测中具有明显优势。
近期,上海理工大学和中国科学院上海技术物理研究所的科研团队在《激光与红外》期刊上发表了以“晶格失配对InAs基室温中波红外探测器性能的影响”为主题的文章。该文章第一作者为段永飞,主要从事新型红外探测材料与器件方面的研究工作;通讯作者为上海理工大学陈泽中副教授,主要从事金属塑性成形CAE与模具CAD/CAM研究等方面的研究工作。
本文研究采用液相外延技术(LPE)生长了InAs基室温红外探测器件材料,通过光学显微镜、扫描电子显微镜、X射线衍射仪分析了外延材料表面形貌、截面形貌与晶格失配的关系。
实验过程
InAs基红外探测器制备
InAs基器件材料的制备采用液相外延法,使用常规水平滑动石墨舟技术进行生长(图1为生长工艺曲线)。外延生长工艺模式采用步冷法,当温度降到生长温度550 ℃时,抽动放置衬底的石墨滑板使InAs衬底依次与熔源材料接触,进行外延层的生长,最终得到InAs基多层薄膜结构器件材料。
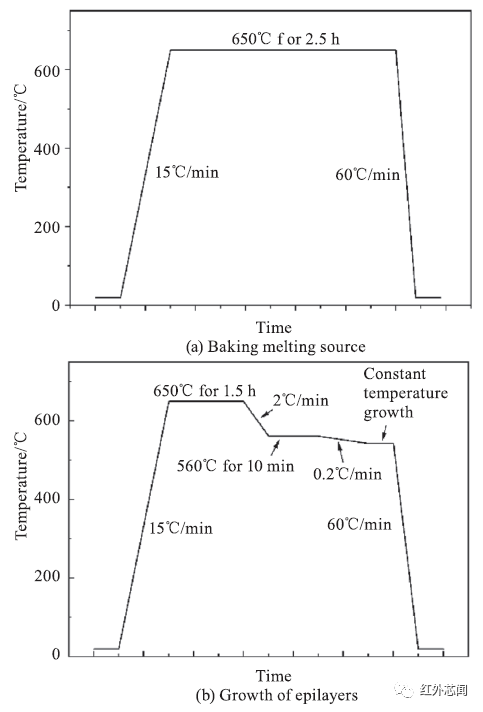
图1 InAs基器件液相外延生长工艺曲线
采用常规光刻和湿法刻蚀工艺)制作直径200 μm台面器件(如图2所示)。在刻蚀出台面结构前,通过匀胶、光刻、显影工艺使用AZ5214光刻胶作为掩膜层将器件台面保护住。采用湿法刻蚀工艺将台面结构以外的外延材料刻蚀掉,刻蚀停止在p型InAsSbP阻挡层。最后,在p型掺杂的InAsSbP阻挡层上和n型掺杂InAsSbP窗口层上利用电子束蒸发做出欧姆接触Ti/Au电极。
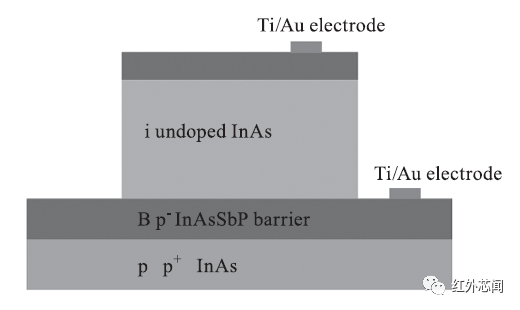
图2 pBin型InAs器件结构示意图
器件性能表征
采用X射线衍射仪(XRD)对样品的结构特性和晶体质量进行表征和分析,测试电压为40 kV,电流为40 mA。采用扫描电子显微镜(SEM)对样品的截面进行观察,测试电压为10 kV。采用I-V测试探针台测试样品的I-V曲线获得器件动态电阻。器件的室温探测率由归一化光电流能谱与黑体响应下探测器光电流相结合得到。采用傅里叶红外光谱仪-获得器件光电流能谱。采用黑体响应测试获得探测器光电流,黑体温度为900 K,调制频率1000 Hz,黑体出光孔径0.8 cm,黑体与探测器的距离为30 cm,探测器输出的光电流信号经前置放大器放大并转化为电压信号后,输入锁相放大器解调后得到。在光电流能谱及黑体响应测试中,探测器均为零偏压状态。
结果与讨论
InAsSbP外延薄膜
通过调整液相外延生长参数如液相组分、生长温度,获得了一系列晶格失配不同的InAsSbP外延薄膜。图3所示为200×放大倍率下的光学显微镜观察的InAsSbP外延薄膜S1~S6样品表面形貌图。采用XRD对InAsSbP外延薄膜的晶格常数和晶体质量进行表征。摇摆曲线的半高宽(FWHM)越窄,单晶的晶格质量越好。图4为S1~S6样品的XRD(400)衍射峰和S1~S6样品InAsSbP外延薄膜的(400)摇摆曲线,外延薄膜与衬底之间的晶格失配通过XRD测得的衍射峰角度代入布拉格方程进行计算。

图3 S1~S6样品光学显微镜表面形貌图
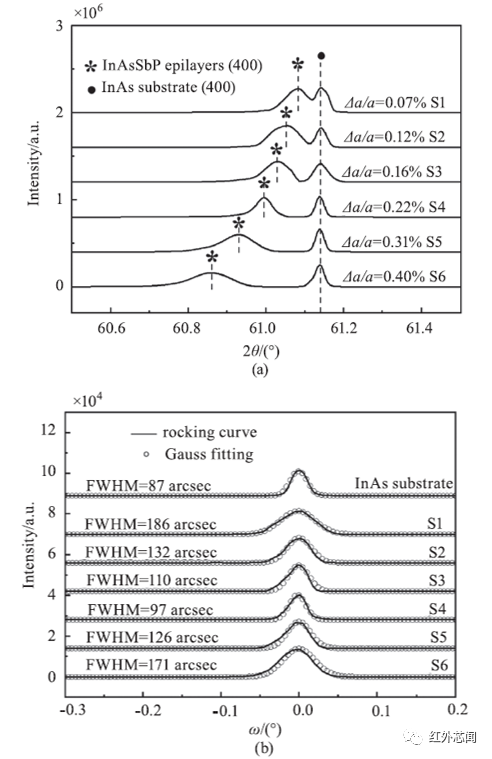
图4 S1~S6样品XRD图及InAsSbP外延膜(400)摇摆曲线图
图3和图4表明,InAsSbP外延层的表面形貌和外延层与衬底之间的晶格失配存在联系。S4样品在室温下与InAs衬底的晶格失配为0.22%,外延层表面光亮均匀,摇摆曲线显示其半高宽最窄,与InAs衬底的摇摆曲线半高宽相当,结晶质量较高。S1和S2样品显示,样品晶格失配在0.1%左右及以下的微正失配时,外延层表面密布点状缺陷。当晶格失配由0.1%左右继续减小至0.1%以下的微小正失配时,点状缺陷密度迅速增加,表面形貌变差,InAsSbP外延层的摇摆曲线半高宽也明显宽化。张永刚等人早期在InAs衬底上使用液相外延技术生长InAsSbP外延层中也有类似情况出现,这可能是因为InAs、InSb和InP的热膨胀系数不同。当晶格失配在0.3%左右继续往正失配方向增加时,“cross-hatch”形貌开始显现,这是液相外延生长过程中一种典型形貌,与位错辅助的应变弛豫和表面台阶流动导致的外延薄膜表面的高低起伏有关。晶格失配增加,“cross-hatch”形貌明显加重,沟壑状纹路出现,说明材料失配位错非常严重,S5和S6样品摇摆曲线的半高宽相比S4样品也有明显宽化,晶格质量变差。
InAs红外探测器件
选取InAsSbP外延层的三种典型表面形貌,生长对应晶格失配0.09%、0.21%、0.40%的InAsSbP外延层组分pBin结构器件,得到样品D1、D2、D3。
采用扫描电子显微镜对各样品的截面进行观察。观察前,将样品沿(100)晶向解理,在A-B腐蚀液中腐蚀3 s。由于样品各层界面处缺陷相比各层材料内部更多,腐蚀速度更快,更容易被刻蚀,因此腐蚀后界面处缺陷更加明显,便于观察到更清晰的界面。各样品的SEM截面形貌如图5所示。样品D1和D3在相同的腐蚀时间下界面处腐蚀很严重,且器件样品的耗尽区即p型InAsSbP阻挡层与本征吸收层之间界面处在腐蚀后相较其他区域发亮并且宽化,缺陷尤为严重。样品D2的SEM截面形貌各外延层间界面平整且清晰,由此可以看出,样品D2各层间缺陷较少,材料质量较高。由此可以判断,晶格失配过大和过小都会导致材料内部缺陷增多,尤其是不同外延层间界面处缺陷密度增加明显。晶格失配在0.21%左右的InAsSbP/InAs系统材料内部缺陷较少,晶体质量较好,这与高分辨X射线衍射谱得到的结果一致。
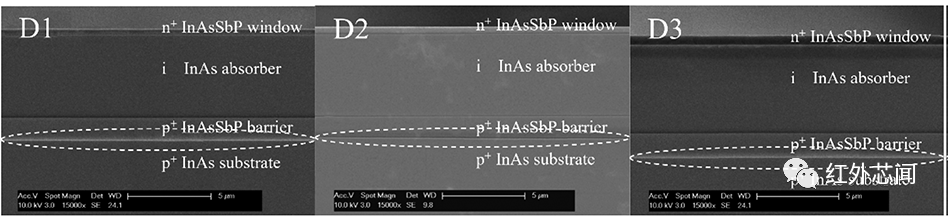
图5 D1、D2、D3器件SEM截面图
将样品D1、D2、D3制备成直径为200 μm的台面型红外探测器器件。图6所示为样品D1、D2、D3制备出的台面型红外探测器的侧壁SEM图。同通过观察SEM截面分析外延层晶体质量原理类似,器件制备过程中的湿法刻蚀工艺也会使材料内部的缺陷扩大。D1和D3样品出现明显侧蚀情况,且D1样品更为严重。对比之下,D2样品表面平整干净,台面形状规则。D2样品材料内部缺陷较少,晶体质量较好,和高分辨X射线衍射谱得到的结果一致。
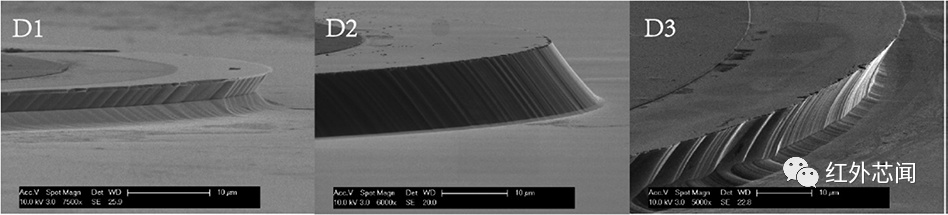
图6 D1、D2、D3器件侧壁SEM图
图7为D1、D2、D3样品制备出的台面型红外探测器的I-V特性曲线。D2样品p-n结特性明显,反向偏压100 mV时漏电流在三个样品中最低,在反向偏压700 mV时仍未出现明显漏电。D1样品在反向偏压100 mV左右时,p-n结开始出现明显漏电,继续增大反向偏压,漏电流急剧增大。D3样品在处于与D1样品相同反向偏压时漏电流比D1样品稍小些,但也在反向偏压200 mV时出现明显漏电。对于pBin结型探测器,其耗尽区位于势垒阻挡层与本征吸收层界面处,零偏电压下,p-n结处于热平衡状态,耗尽区中非平衡载流子的产生速率等同于复合速率,附加偏压后,耗尽区内部缺陷密度如果较大,杂质和缺陷将形成大量的载流子产生复合中心,导致器件的产生复合电流大幅增加。对比三个晶格失配不同的样品,晶格失配在0.21%的器件样品D2暗电流水平最低。
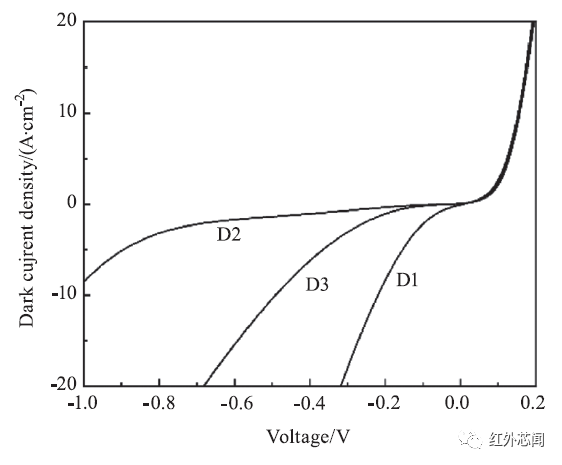
图7 D1、D2、D3器件I-V曲线
对D2样品台面型红外探测器室温探测性能进行了测试。D2样品台面型红外探测器的室温光学响应率和探测率如图8所示。900 K黑体辐照下,器件室温下截止波长为3.5 μm,探测率D*为6.8×10⁹ cm·Hz1/2·W⁻¹,这一性能和国际上红外探测器领军企业美国Teleyne Judson Techologies(截止波长3.60 μm,室温探测率2.5~3.7×10⁹ cm·Hz1/2·W⁻¹)和日本滨松株式会社(截止波长3.65 μm,室温探测率4.5×10⁹ cm·Hz1/2·W⁻¹)在售的商用InAs基红外探测器处于同一水平。


图8 D2器件室温光学响应率图及探测率图
结论
本文采用液相外延技术制备了以InAsSbP材料为器件阻挡层和窗口层材料的InAs基红外探测器,研究了InAsSbP/InAs系统的晶格失配对InAs基红外探测器性能的影响。通过对一系列晶格失配不同的InAsSbP外延薄膜分析发现,不恰当的晶格失配会造成InAsSbP外延层缺陷增多,结晶质量下降。确定出了晶格失配在0.22%左右的InAsSbP外延层晶体质量较好,采用0.22%左右晶格失配的方案制备出的器件暗电流水平较低。通过对InAsSbP/InAs系统晶格失配的研究,制备出了InAs基红外探测器件,并测试得出室温下截止波长为3.5 μm,探测率D*为6.8×10⁹ cm·Hz1/2·W⁻¹,室温探测率已达到较高水平。
 成都微光集电推出车规级应用-2MP高帧率、高动态范围图像传感器
成都微光集电推出车规级应用-2MP高帧率、高动态范围图像传感器